MOS-gated Prebond Through-Silicon Via Testing
-
摘要: 在集成芯片的制造过程中,硅通孔(TSV)中可能会出现许多缺陷,这些缺陷会影响通过硅通孔信号的完整性,因此在早期生产阶段检测这些缺陷至关重要。现有的测试方法存在测试面积和时间开销大、测试精度低的问题。该文选择N型金属氧化物半导体场效应管(NMOS)和P型金属氧化物半导体场效应管(PMOS)作为选通门,以减小共享测试的面积开销;采用两级电压比较器放大测试TSV和参考电容的电压差,可以检测大于等于50 Ω的电阻性开路缺陷和小于等于9 MΩ的泄漏缺陷。 与其他方案对比,该方案具有电阻性开路缺陷检测精度高、最小的测试面积和时间开销的优点。Abstract:
Objective As the miniaturization of semiconductor chips approaches physical limitations, integrated chip technologies have become essential to meet the demand for high-performance, low-cost devices in the post-Moore era. Through-Silicon Via (TSV) is a key process in advanced packaging that requires precise testing to ensure reliable interconnections. Quantitative test methods can estimate defect sizes based on test responses; however, variations in Process, Voltage, and Temperature (PVT) hinder accurate defect characterization, making the associated overhead of data capture and analysis difficult to justify. Current techniques often require long test time, with some necessitating two test cycles. While leakage defect detection has reached high accuracy, the detection of resistive open defects—sometimes only tens of milliohms in fault-free states, remains inadequate. This study presents a method that improves detection accuracy for resistive open defects and reduces both test area and time overhead, offering a more efficient and practical TSV testing solution. Methods Previous studies indicate that rising-edge testing provides higher resolution than falling-edge testing and enables simultaneous differentiation of multiple defect types. Based on this principle, a symmetric testing scheme through a single rising-edge test is proposed. To reduce the area overhead associated with shared test structures, MOS gates are employed as selection switches. NMOS transistors, due to their strong 0 and weak 1 characteristics, are placed at the driving end to enable rapid discharge and reset of the reference capacitor voltage. PMOS transistors, exhibiting strong 1 and weak 0 characteristics, are positioned at the receiving end to block interference from low-voltage signals. A two-stage comparator is then employed to amplify the voltage difference between the reference capacitor and the test TSV during the charging phase, producing two intermediate voltage levels. These are subsequently converted into standard high or low logic levels by a Schmitt trigger inverter. Based on the output logic level, both the presence and type of defect can be determined from a single test. Results and Discussions The effectiveness of the proposed method is verified through HSPICE simulations using the Nangate 45 nm open cell library. The detection accuracy for different defect types is modulated by adjusting the Width-to-Length (W/L) ratio of the MOS transistors, as shown in ( Table 2 ). For instance, reducing the W/L ratio of NMOS transistors enhances the detection sensitivity to leakage defects. Specific W/L ratios can therefore be selected to meet targeted testing requirements. (Table 3 ) presents the results under PVT variations. Although the accuracy shows minor fluctuations, these remain within acceptable limits. A temperature variation of approximately 27 °C results in only a 1 Ω deviation in resistive open defect detection, and a 1 MΩ range in leakage defect accuracy. Even under the worst-case PVT condition, the minimum detection threshold for resistive open defects reaches 94 Ω, which exceeds the capability of existing methods.Conclusions A prebond TSV testing scheme based on MOS gating is proposed to address the high area and time overheads and limited accuracy of conventional approaches. The scheme adopts a symmetric structure between the reference capacitor and the test TSV to mitigate capacitance variation caused by fabrication inconsistencies. A two-stage comparator amplifies the voltage difference between the defective TSV and the reference capacitor during charging, thereby enhancing detection resolution. Simulation results indicate that the method detects resistive open defects equal of above 50 Ω and leakage defects equal of below 9 MΩ. Compared with existing methods, the proposed approach significantly reduces both testing area and time. When multiple TSVs share the testing circuitry, only one NMOS and one PMOS transistor are added, further minimizing the average area overhead. -
Key words:
- Integrated chip /
- Through-Silicon Via (TSV) /
- Prebond test /
- Comparator
-
表 1 实验参数
参数 值 无故障TSV CTSV=60 fF, Rleak=1 TΩ 电压VDD 1 V(10%) NMOS,PMOS: W/L 4/1(180 nm/45 nm) Crefi 60 fF 比较器分辨率 13 mV 表 2 测试精度与MOS管宽长比的关系
MOS管宽长比 Ropen(Ω) Rleak(MΩ) NMOS: 4/1; PMOS: 4/1 50 9 NMOS: 6/1; PMOS: 4/1 47 5 NMOS: 8/1; PMOS: 4/1 44 3 PMOS: 6/1; NMOS: 4/1 51 8.4 PMOS: 8/1; NMOS: 4/1 52 8.0 表 3 不同PVT下的测试精度
工艺 温度(℃) 电压(V) Ropen(Ω) Rleak(MΩ) TT 27 1.0 50 9 SS 27 1.0 88 25 FF 27 1.0 47 3 TT –30 1.0 53 7 TT 0 1.0 51 8 TT 60 1.0 51 10 TT 125 1.0 52 12 TT 27 0.9 94 14 TT 27 1.1 29 7 -
[1] DEBENEDICTIS E P, BADAROGLU M, CHEN An, et al. Sustaining Moore’s law with 3D chips[J]. Computer, 2017, 50(8): 69–73. doi: 10.1109/MC.2017.3001236. [2] THADESAR P A, GU Xiaoxiong, ALAPATI R, et al. Through-silicon Vias: Drivers, performance, and innovations[J]. IEEE Transactions on Components, Packaging and Manufacturing Technology, 2016, 6(7): 1007–1017. doi: 10.1109/TCPMT.2016.2524691. [3] HWANG Y, MOON S, NAM S, et al. Chiplet-based system PSI optimization for 2.5D/3D advanced packaging implementation[C]. 2022 IEEE 72nd Electronic Components and Technology Conference (ECTC), San Diego, USA, 2022: 12–17. doi: 10.1109/ECTC51906.2022.00010. [4] LAU J H. Recent advances and trends in multiple system and heterogeneous integration with TSV interposers[J]. IEEE Transactions on Components, Packaging and Manufacturing Technology, 2023, 13(1): 3–25. doi: 10.1109/TCPMT.2023.3234007. [5] LAU J H. Recent advances and trends in advanced packaging[J]. IEEE Transactions on Components, Packaging and Manufacturing Technology, 2022, 12(2): 228–252. doi: 10.1109/TCPMT.2022.3144461. [6] JUNG D H, KIM Y, KIM J J, et al. Through Silicon Via (TSV) defect modeling, measurement, and analysis[J]. IEEE Transactions on Components, Packaging and Manufacturing Technology, 2017, 7(1): 138–152. doi: 10.1109/TCPMT.2016.2631731. [7] ZHAO Yi, KHURSHEED S, and AL-HASHIMI B M. Online fault tolerance technique for TSV-based 3-D-IC[J]. IEEE Transactions on Very Large Scale Integration (VLSI) Systems, 2015, 23(8): 1567–1571. doi: 10.1109/TVLSI.2014.2343156. [8] CHANDRAKAR M and MAJUMDER M K. Performance analysis using air gap defected through silicon via: Impact on crosstalk and power[J]. IEEE Transactions on Components, Packaging and Manufacturing Technology, 2022, 12(11): 1832–1840. doi: 10.1109/TCPMT.2022.3225142. [9] XU Kangkang, YU Yang, and FANG Xu. The detection of open and leakage faults for Prebond TSV test based on weak current source[J]. IEEE Transactions on Computer-Aided Design of Integrated Circuits and Systems, 2022, 41(9): 2768–2779. doi: 10.1109/TCAD.2021.3114357. [10] LIU Jun, CHENG Songren, CHEN Tian, et al. A self-biased current reference source-based pre-bond TSV test solution[J]. IEEE Transactions on Very Large Scale Integration (VLSI) Systems, 2024, 32(4): 774–781. doi: 10.1109/TVLSI.2023.3344272. [11] DAS S, SU F, and CHAKRAVARTY S. A PVT-resilient no-touch DFT methodology for prebond TSV testing[C]. 2018 IEEE International Test Conference (ITC), Phoenix, USA, 2018: 1–10. doi: 10.1109/TEST.2018.8624691. [12] YI Maoxiang, BIAN Jingchang, NI Tianming, et al. A pulse shrinking-based test solution for Prebond through silicon via in 3-D ICs[J]. IEEE Transactions on Computer-Aided Design of Integrated Circuits and Systems, 2019, 38(4): 755–766. doi: 10.1109/TCAD.2018.2821559. [13] LIU Jun, CHEN Zhi, CHEN Tian, et al. Voltage skew-based test technique for pre-bond TSVs in 3-D ICs[J]. IEEE Transactions on Circuits and Systems II: Express Briefs, 2024, 71(8): 3930–3934. doi: 10.1109/TCSII.2024.3373897. [14] WANG Lihang, DONG Gang, ZHI Changle, et al. Prebond TSV detection for coexistence of open and leakage faults based on current charging and discharging[J]. IEEE Transactions on Components, Packaging and Manufacturing Technology, 2025, 15(5): 1091–1103. doi: 10.1109/TCPMT.2025.3543693. [15] CHANG Hao, HUANG Zhengfeng, and NI Tianming. Kelvin bridge structure based TSV test for weak faults[C]. 2021 IEEE International Test Conference in Asia (ITC-Asia), Shanghai, China, 2021: 1–6. doi: 10.1109/ITC-Asia53059.2021.9808492. [16] LIU Jun, CHEN Zhi, CHENG Songren, et al. A symmetric bridge-based pre-bond TSV faults detection method[J]. IEEE Transactions on Instrumentation and Measurement, 2024, 73: 2004710. doi: 10.1109/TIM.2024.3427774. -





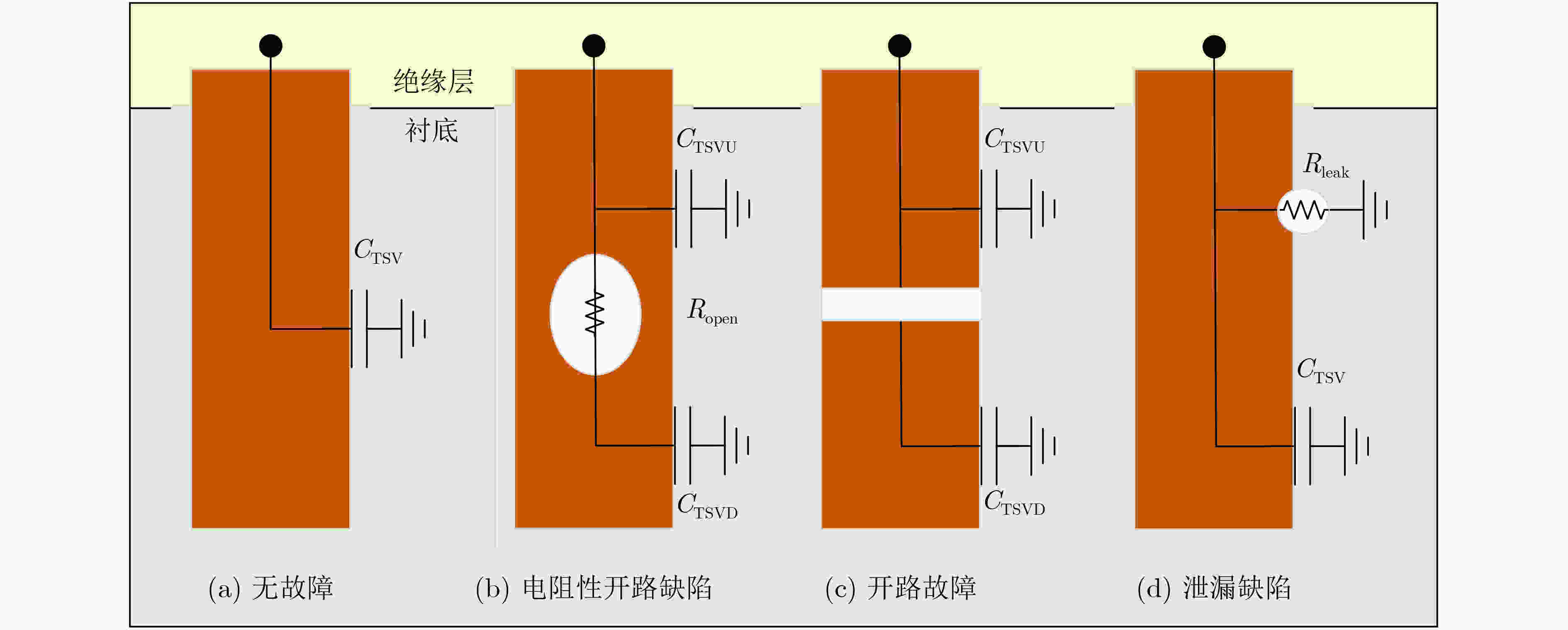
 下载:
下载:
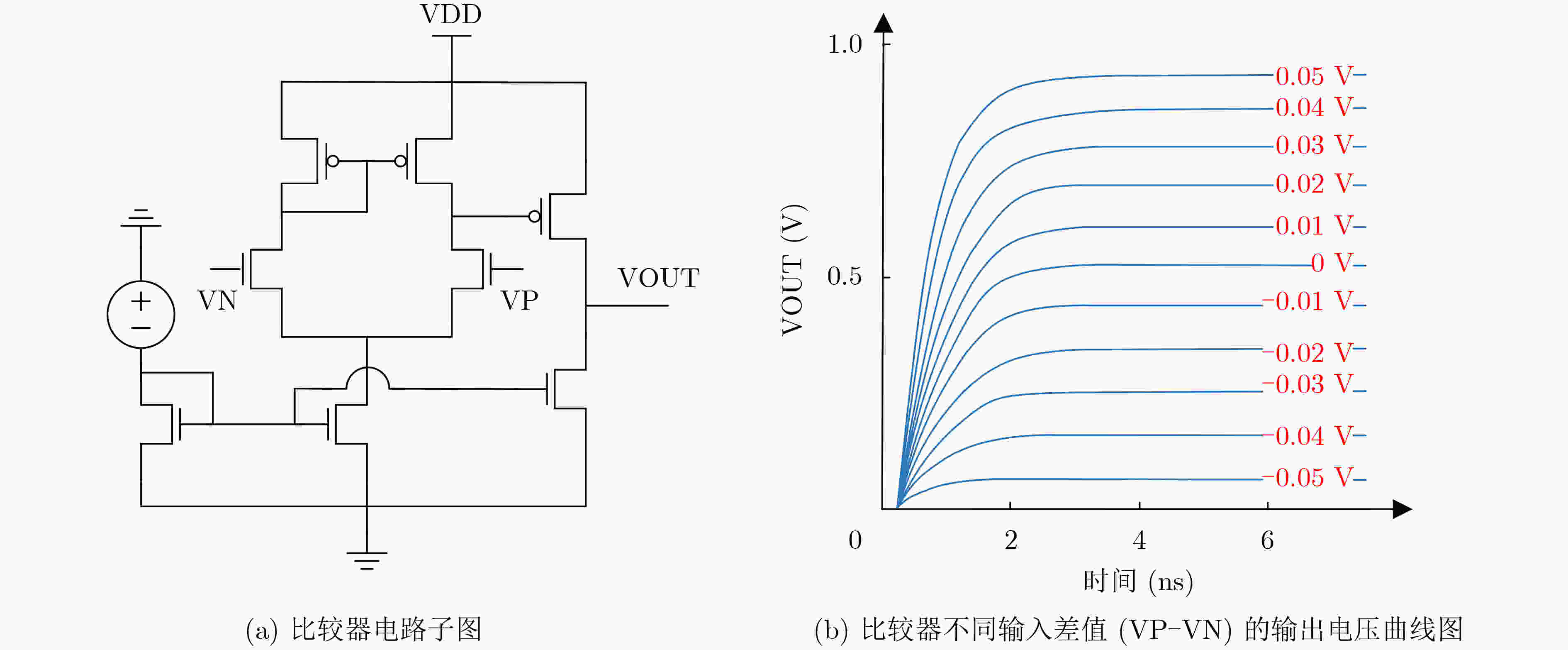
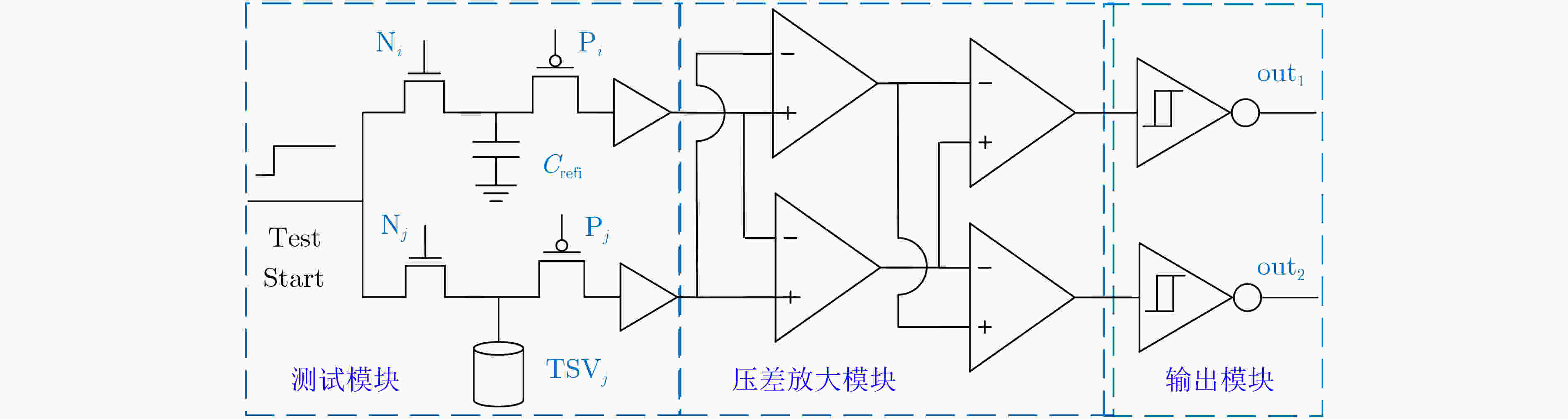


 下载:
下载:
